PLD 装置 (Pulsed Laser Deposition System) 詳細はお問い合わせ下さい
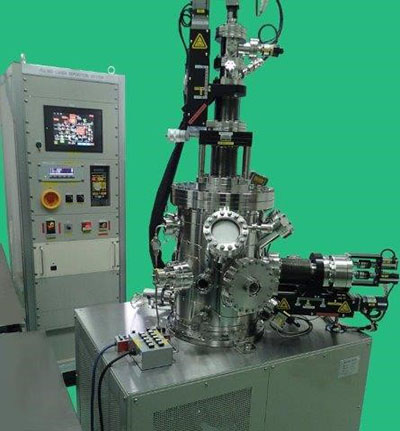
| 装置名称 | PLD装置 (Laser MBE) | 備考 |
|---|---|---|
| 型式 | PLD-203S-2 (成膜室+準備室+RHEED) |
|
| 成膜室 | 340(ID)X500(H) mm, 電解研磨 | シースヒーター巻き |
| ターゲット | ⌀1”x5個, 自公転機構(汚れ防止有) | 寸法、数量調整可能 |
| ヒーター | 耐酸化PBNヒーター,温度1200℃以上 | 他の加熱方式選択可 |
| 基板 | ⌀1”,温度900以上, 5軸マニピュレータ | 基板サイズ変更可能 |
| 真空度 | 5X10-6Pa以下 (成膜室) | 真空ポンプ変更可能 |
| ガス導入系 | MFC+ストップバルブ, 2系統 | 必要に応じて変更 |
| 準備室 | 真空5X10-5Pa以下,ロードロック機構 | 他の機構増設可能 |
| オプション | RHEED画像処理システム,RFラジカル源,成膜ソフト等 | |
| 設置及電源 | 寸法: 150(W)X120(D)X200(H) cm 電源:単相 200V 60A | |
スパッタ装置 (Sputtering System) 詳細はお問い合わせ下さい
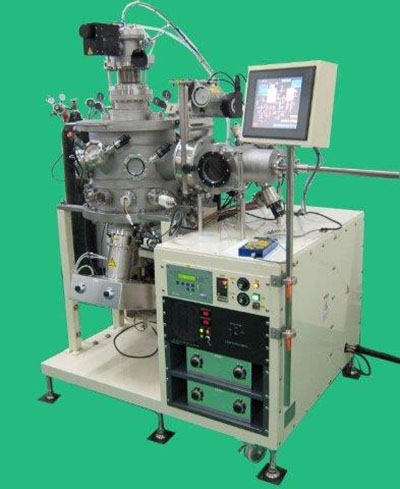
| 装置名称 | スパッタ装置 (スタンダード) | 備考 |
|---|---|---|
| 型式 | ASP-323-1(成膜室+準備室) | |
| 成膜室 | 380(ID)X400(H) mm, G.B.B処理 | 水冷パイプ巻き |
| スパッタ源 | ⌀2”x3元, マグネトロン水冷式 | 自動シャッター付 |
| 電源 | RF電源500W 自動マッチング 1台 | 電源の切替、電源数 量種類変更可能 |
| DC電源800V 1000W 1台 | ||
| 基板 | サイズ⌀3”,ランプ加熱, 温度500以上 | Z軸駆動器S=100付 |
| 真空度 | 5X10-5Pa以下 (成膜室) | 真空ポンプ変更可能 |
| ガス導入系 | MFC+ストップバルブ, 3系統 | 必要に応じて変更 |
| 準備室 | 真空度5X10-5Pa以下,ロードロック機構, 補助ポンプ共用 | |
| 設置及電源 | 寸法: 150(W)X120(D)X180(H) cm 電源:単相 200V 60A | |
電子デバイス作製システム (Electric Device Fabrication System) 詳細はお問い合わせ下さい

| 装置名称 | 小型電子デバイス作製システム | 備考 |
|---|---|---|
| 型式 | SOED-50-3(蒸着+スパッタ+GB) | |
| 蒸着室 | 210(ID)X300(H) mm, G.B.B処理 | 上蓋開閉式 |
| 蒸着源 | ボート又はフィラメント, 各1セット | 蒸着源種類変更可能 |
| スパッタ源 | ⌀1.3”x1元, DC電源 300W | RF電源変更可能 |
| 基板 | サイズ50×50, 膜厚計 1式 | 加熱or水冷可能 |
| 真空度 | 5X10-5Pa以下 | 真空ポンプ変更可能 |
| GB | 不活性ガス循環,真空対応 | サイズ変更可能 |
| オプション | 膜厚計等 | 必要に応じて増設 |
| 設置及電源 | 寸法:180(W)X120(D)X190(H) cm 電源:単相 200V 50A | |
電子ビーム蒸着装置 (Electron Beam Evaporation) 詳細はお問い合わせ下さい

| 装置名称 | 電子ビーム蒸着装置 (3連E型) | 備考 |
|---|---|---|
| 型式 | SEB-31-4 | |
| 蒸着室 | 330(ID)X600(H) mm, 電解研磨 | 水冷パイプ巻き |
| 電子銃 | 2KW 3連E型, ルツボ容量1ml | 電子銃型式変更可能 |
| 加熱 | ランプヒーター, 温度500℃以上 | 加熱方式変更可能 |
| 基板 | サイズ⌀2” ,シャッター付 | 基板自転 |
| 真空度 | 7.5X10-6Pa以下 | 真空ポンプ変更可能 |
| 膜厚計 | オンライン膜厚測定監視 | 必要に応じて変更 |
| その他 | アクセッス扉、インターロック等付 | |
| オプション | 準備室、イオンソース等 | 必要に応じて増設 |
| 設置及電源 | 寸法:150(W)X120(D)X190(H) cm 電源:単相 200V 50A | |
デュアルイオンソース蒸着装置 (Dual Ion Source Deposition System) 詳細はお問い合わせ下さい
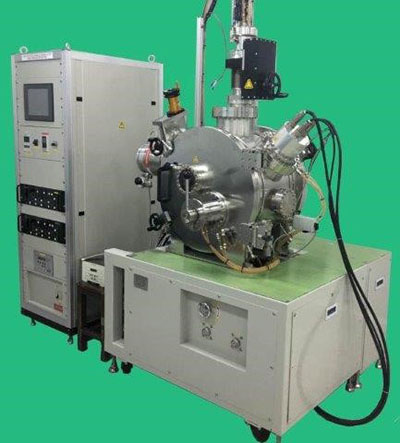
| 装置名称 | デュアルイオンソース蒸着装置 | 備考 |
|---|---|---|
| 型式 | AIBD-464-1 | |
| 蒸着室 | 560(ID)X460(H) mm, 電解研磨 | 水冷パイプ巻き |
| ソース1 | ⌀75mm,ビーム 1200V, 363mA | DCイオンソース |
| ソース2 | ⌀40mm,ビーム 1200V, 130mA | DCイオンソース |
| ターゲット | 6”角 X 4面, 水冷 | 公転機構付 |
| 基板 | ⌀4”,加熱温度500℃以上 | 回転、シャッター付 |
| 真空度 | 5X10-5Pa以下 | 真空ポンプ変更可能 |
| オプション | 準備室、膜厚計等 | 必要に応じて増設 |
| 設置及電源 | 寸法:240(W)X150(D)X210(H) cm 電源:単相 200V 60A | |